金絲球焊工藝在光模塊加工中的應(yīng)用
發(fā)布時(shí)間:2023-10-09
1. 金絲球焊簡介
金絲球焊又稱金絲鍵合,其作為半導(dǎo)體內(nèi)部引線互連的主流工藝,廣泛應(yīng)用于集成電路中的芯片封裝及有源光器件中芯片與外部引腳的互連。
市面上常見的金絲球焊設(shè)備的原理是:金絲在設(shè)備瞬間高壓放電時(shí),尾端形成一個(gè)細(xì)小的金球(也稱FAB,Free Air Ball),利用超聲頻率的機(jī)械振動,使金球與被焊材料表面接觸產(chǎn)生塑性形變,在超聲輔以溫度及壓力的條件下,使金屬表面原子外層電子相互結(jié)合而形成接點(diǎn)。
影響金絲球焊效果常見內(nèi)部因素主要有四個(gè):超聲輸出功率、溫度、壓力以及焊接時(shí)間,同時(shí)也受一些外部因素的影響,例如金絲的規(guī)格、焊點(diǎn)材料、焊點(diǎn)表面潔凈度、走線形狀等。
光器件加工中常用25um的金絲進(jìn)行器件內(nèi)部引腳互連,主要是基于金這種金屬良好的延展性(可以拉成足夠細(xì)的絲線并保證足夠的拉力)、導(dǎo)電性、可焊性,以滿足通信半導(dǎo)體精細(xì)的加工要求及高質(zhì)量的電信號傳輸要求。
2. 金絲球焊在光模塊生產(chǎn)中的應(yīng)用
金絲球焊在光模塊生產(chǎn)中最常見的兩個(gè)應(yīng)用,其一是應(yīng)用于TO-CAN的加工,另一個(gè)則是COB加工工藝。
2.1 TO-CAN加工
光器件中的TO-CAN工藝是指將裸芯片(Die)通過環(huán)氧膠或金錫焊料等材料固化在TO金屬底座(一般底座都采用表面鍍金的可伐合金材料)上,通過金絲球焊將內(nèi)部的引腳及TO上的引腳相互連接形成目標(biāo)電路,再通過氣密封裝的方式將DIE及引線保護(hù)起來。
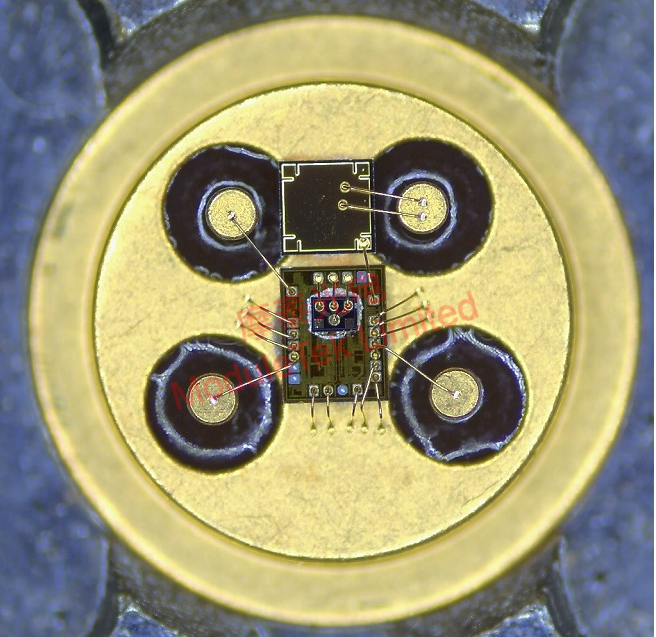
圖1 TO-CAN內(nèi)部金絲球焊示意圖
2.2 COB加工
COB(Chip-on-Board)工藝,是指將裸芯片(Die)直接固定在印刷電路板上,然后通過金絲鍵合,再將芯片和引線進(jìn)行封裝保護(hù)的工藝,在信號完整性上具有更好優(yōu)勢,逐步成為高速光模塊封裝的主流工藝之一。
COB工藝中的金絲球焊的質(zhì)量除受本身的參數(shù)設(shè)置因素外,電路板的表面處理工藝也是影響金絲焊接效果的一個(gè)重要因素,目前市場上COB電路板推崇的表面工藝是鎳鈀金工藝。COB工藝詳情可查看:光模塊COB工藝介紹。
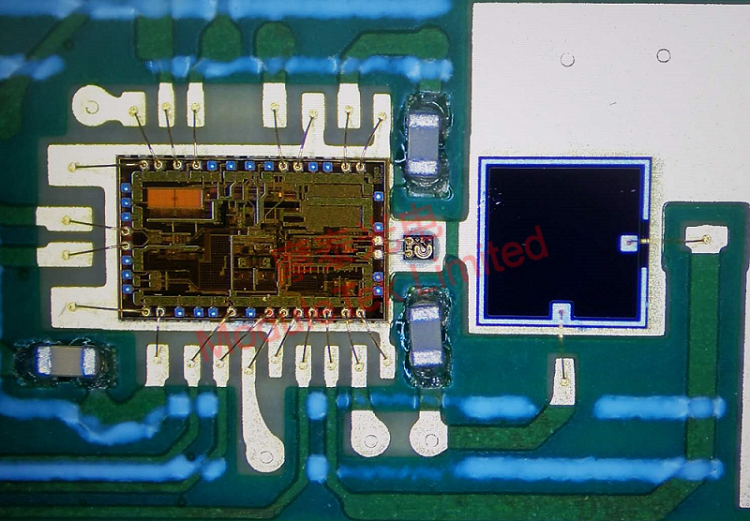
圖2 光模塊中COB金絲球焊示意圖
摩泰光電可提供使用金絲球焊工藝生產(chǎn)加工的光模塊產(chǎn)品,歡迎大家選購!

 40G/100G 光模塊
40G/100G 光模塊 25G 光模塊
25G 光模塊 10G 光模塊
10G 光模塊 155M/2.5G 光模塊
155M/2.5G 光模塊 1G 光模塊
1G 光模塊 1G BIDI 光模塊
1G BIDI 光模塊 雙速率 光模塊
雙速率 光模塊 FC 16G/32G光模塊
FC 16G/32G光模塊 CWDM 光模塊
CWDM 光模塊 DWDM 光模塊
DWDM 光模塊 SGMII端口 光模塊
SGMII端口 光模塊 XFP 光模塊
XFP 光模塊 100M/1G/10G 電口模塊
100M/1G/10G 電口模塊 全速率AOC及分支系列
全速率AOC及分支系列 10G/40G 有源DAC系列
10G/40G 有源DAC系列 全速率無源DAC系列
全速率無源DAC系列 40G/100G 無源DAC分支系列
40G/100G 無源DAC分支系列 常規(guī)/MTP-MPO 光纖跳線
常規(guī)/MTP-MPO 光纖跳線 MT2010
MT2010 MT2011
MT2011 CodingBox
CodingBox QSFP轉(zhuǎn)SFP模塊
QSFP轉(zhuǎn)SFP模塊






